半导体和微电子
激光微射流在特定行业中的优势
与常规金刚石锯切或激光系统相比,Synova独特的微水射流激光®加工系统为半导体行业和微电子行业的应用提供了多项独特优势。
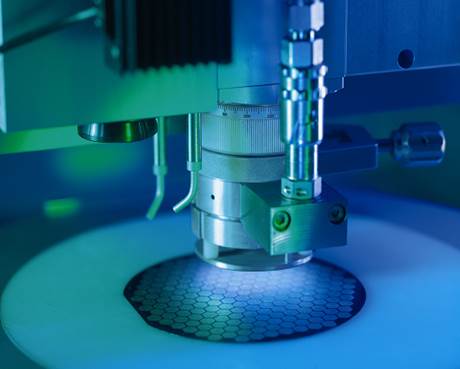
激光微射流® (LMJ®)技术的“温和”加工方式满足敏感的半导体材料的切割、开槽和切割的日益增强的质量要求,达到光滑垂直的切边、保持材料的高晶圆断裂强度、并显著降低破损风险。灵活的LMJ®加工技术实现精确烧蚀各种半导体材料,例如硅 (Si)、砷化镓 (GaAs)、碳化硅 (SiC)、低介电质材料,包括其不同涂层材料,例如不同厚度的环氧树脂模塑化合物涂层的晶片划片。LMJ®机器能够进行多向 2D 切割,使工程师能够创建新的 T 型切割和圆形设计的芯片形状的设计切毫无二致的高质量。另外,随着Multiple-Project Wafer(MPW)多项目晶圆切的崛起,常规锯切几乎难以进行划片,考虑常规“干”激光划片工艺的局限性,激光微射流技术则在其固有优势的加持下,体现了独特的工艺优势。
不同的激光源(绿光、紫外光、红外光)可以被考虑在LMJ®加工系统中,以应对未来不同需求的应用挑战。Synova 的LMJ®系统具有整体高性价比优势的加工技术,整体的耗材成本和对整个加工工艺的良性影响的复合实现了这个可能性。同时,随着晶圆厚度的持续降低和衬板材料刚性的增加和材料特性的变化,比如碳化硅SiC衬板的采用,常规锯切和激光划片技术遭遇了前所未有的挑战,而SYNOVA公司的激光微射流其无热影响区(HAZ)、被冲刷的加工碎屑、无微裂纹、无毛刺/沉积、垂直切面、低粗糙度等特征完美地应对了这些挑战,使客户能够可能通过采用激光微射流加工技术实现业务的综合效益。
- 性能
- 高精度+/-3 μ m的公差
- 可切割任何形状(2D)
- 高切割速度:对于薄晶圆(<50 µm),切割速度高达 200 mm/sec
- 正常晶圆厚度范围:50 µm - 2 mm
- 最大单次烧蚀线速度1000 mm/s
主 要 应 用
| 开槽/切割用于LED和手机的蓝宝石晶圆
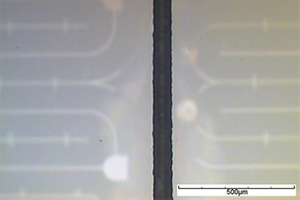
在蓝宝石衬底上开槽

在蓝宝石衬底上开槽
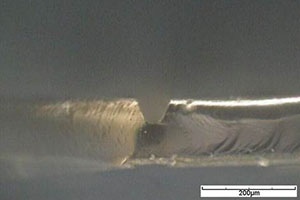
在蓝宝石衬底上开槽
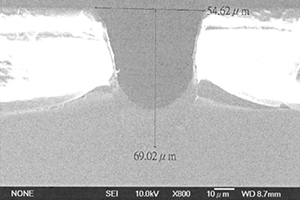
在蓝宝石衬底上开槽
| 划片薄型低介电质晶圆

薄型低介电质晶圆

薄型低介电质晶圆
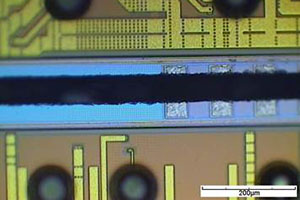
薄型低介电质晶圆
| 晶圆修边和晶圆的大切小(去除缺陷部分)

移除前的晶圆

去除后的晶圆边缘
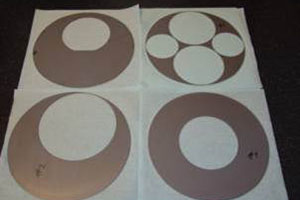
晶圆缩小
| 太阳能电池的电池边缘隔离

太阳能电池
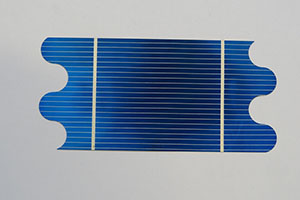
太阳能电池

太阳能电池
客户样品申请表Customer Sample Request Form(CSRF)

